東工大ニュース
東工大ニュース
公開日:2015.03.09
東京工業大学大学院理工学研究科の松澤昭教授と岡田健一准教授らは、パルス状の逆電圧を印加するという電気的な手法を用い、ホットキャリア注入現象[用語1]により劣化したトランジスタの性能を回復させる新技術を開発した。この回復機構をミリ波帯無線機に組み込み、低下した出力電力が回復できることを世界で初めて実証した。
製品出荷後のトランジスタはホットキャリア注入により経時的に劣化が進み、それが製品寿命を決める主要因の一つだった。劣化を高温ベークにより回復する方法はあったが、専用の装置が必要だった。新技術は回路に組み込むだけで性能を回復できる。
回復機構を組み込んだミリ波帯無線機を、最小配線半ピッチ65nm(ナノメートル) のシリコンCMOSプロセスで試作し、出力電力の回復を確認した。この技術が実用化されれば、半導体集積回路の製品寿命を自由に調整することができるようになる。
研究成果は2月22日から米国サンフランシスコで開かれた「ISSCC(国際固体回路国際会議)」で2月25日に発表された。
現在、ほぼすべての半導体集積回路で用いられるCMOS技術は微細化により、高速に動作する一方で、信頼性の問題が顕在化している。トランジスタのドレイン-ソース間の距離が短くなっている一方で、電源電圧はあまり下がっていないため、相対的にドレイン-ソース間の電界が強くなっている。キャリアがこの電界で加速され、稀(まれ)に非常に高いエネルギーを持つホットキャリアが生成される。このようにチャネル中で加速されたホットキャリアや、ドレイン近傍での高電界で加速され電離衝突により発生したホットキャリアは、ゲート酸化膜に注入され、そのまま浮遊電荷としてトラップされる(図1)。ホットキャリア注入(HCI : Hot Carrier Injection)と呼ばれる現象である。
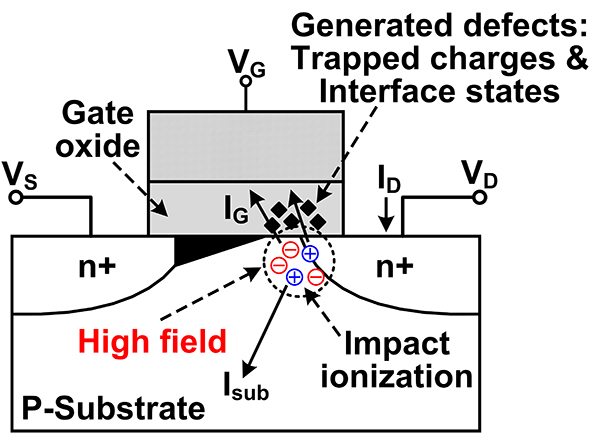
図1. CMOSトランジスタの断面
特徴:CMOSトランジスタが微細化されるほど、横方向電界が強まり、キャリア(n形の場合は電子)が過剰に加速され、ホットキャリア注入の発生頻度が高まる。
トラップされたキャリアは、しきい値電圧の上昇や移動度の低下を引き起こし、結果として電流値が減少する。デジタル回路では動作速度が低下し、アナログ回路では利得が減少するなどの問題を起こし、回路性能を低下させる。経時的に劣化が進んでいくため、最終的には所望の性能を満たせなくなり、動作不良を起こす。CMOSトランジスタの寿命を決める主要な物理現象の一つになっている。従来、高温ベークにより劣化を回復する方法があったが、高温ベークのための専用装置が必要だった。
東工大の松澤教授と岡田准教授らは、ホットキャリア注入によるダメージを、トランジスタにパルス状の逆電圧を印加するという電気的な手法で回復させることに成功した。パルス状の逆電圧を印加することにより、ゲート酸化膜中にトラップされたキャリアを減少させ、ホットキャリア注入によるダメージからCMOSトランジスタを回復させることができる(図2)。
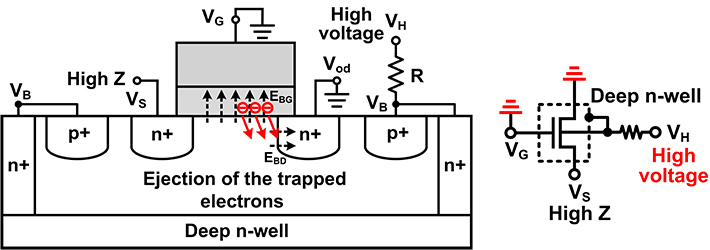
図2. 逆バイアス印加によるホットキャリア注入ダメージの回復
特徴:ドレインおよびゲート端子を接地し、基板電位を瞬間的に上げることで、トラップされたキャリアを抜き、ホットキャリア注入ダメージを回復する。
代表的な不揮発性メモリー(電源を切っても記憶を保持できるメモリー)であるフラッシュメモリーでは、順電圧・逆電圧を印加することにより、ソース・ドレイン間のチャネル領域から、ゲート電極の間に配置された浮遊ゲートへ意図的に電荷を貯めたり抜いたりすることで動作する。このフラッシュメモリーの動作に着想を得て、浮遊ゲート中の電荷だけでなく、ホットキャリア注入による酸化膜中の電荷を抜くことができないかと考えたのが、今回の技術開発の発端である。
最小配線半ピッチ65nm(ナノメートル)のシリコンCMOSプロセスで試作したトランジスタで試験した(図3)。トランジスタ単体のドレイン電流を測定すると、ダメージを受けていない状態(Fresh)から、ホットキャリア注入により徐々に電流が減少する(Damaged)。開発した技術を用いると、電流値を回復できる(Healed)ことを確認した。
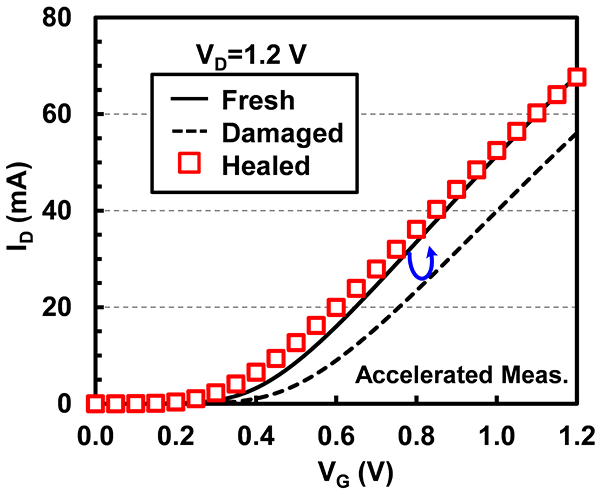
図3. ホットキャリア注入ダメージによる電流の減少および回復
特徴:ダメージを受けていない状態(Fresh)から、ホットキャリア注入により徐々に電流が減少する(Damaged)。提案技術を用いることにより、電流値を回復できる(Healed)。
次に、回復機構を実際に組み込んだ60GHz(ギガヘルツ)帯ミリ波無線機を、最小配線半ピッチ65nmのシリコンCMOSプロセスで試作した。無線機で必要とされる電力増幅器は、出力電力を高くとるために、大きな電圧振幅が必要であり、特にホットキャリア注入によるダメージを受けやすい回路である電力増幅器としての動作と、回復のための逆電圧印加を可能とする新たな回路構成を考案した(図4)。無線機全体の回路図を図5に示す。図6にチップ写真および各部の面積を示す。非常に小面積で回復機構の実装に成功した。
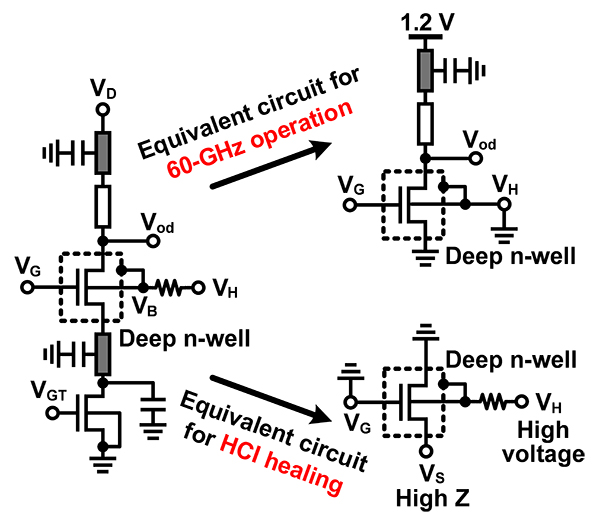
図4. 電力増幅器への組み込み
特徴:通常の電力増幅器としての動作とホットキャリア注入回復動作を両立。

図5. ホットキャリア注入ダメージ回復が可能な60GHz無線機のブロック図
特徴:ホットキャリア注入ダメージの回復技術(HCI healing)を組み込んだ60GHz帯無線機
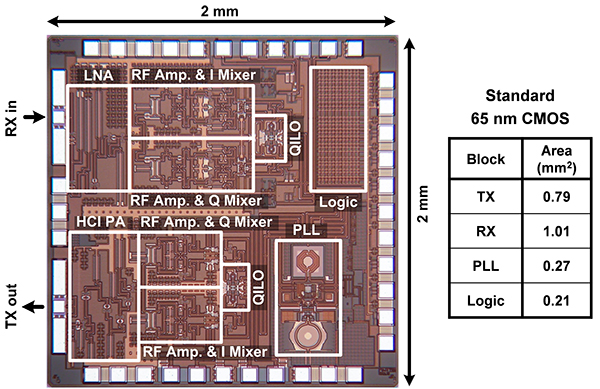
図6. チップ写真と各部の面積
特徴:CMOS 65nmプロセスにより製造した。
無線機としての出力電力と変調精度(EVM)の実測結果を図7に示す。IEEE802.11ad規格[用語2]準拠のために、EVM<=-21dBの変調精度を満たす必要がある。EVM=-21dBの条件で、元々の出力電力が8.5mW(Fresh)であったが、HCIダメージ(電源電圧Vdd=1.5V, 出力電力17.8mWのストレス条件で40時間)により、出力電力が3.4mW(Damaged)にまで減少する。本技術により、6.0mW(Healed)まで回復できることを確認した。
従来、ホットキャリア注入によるダメージは経時的に蓄積し、製品寿命を決める大きな要因の一つであった。この技術が実用化されれば、製品出荷後においてもホットキャリア注入による性能劣化を回復でき、半導体集積回路製品の長寿命化が期待できる。
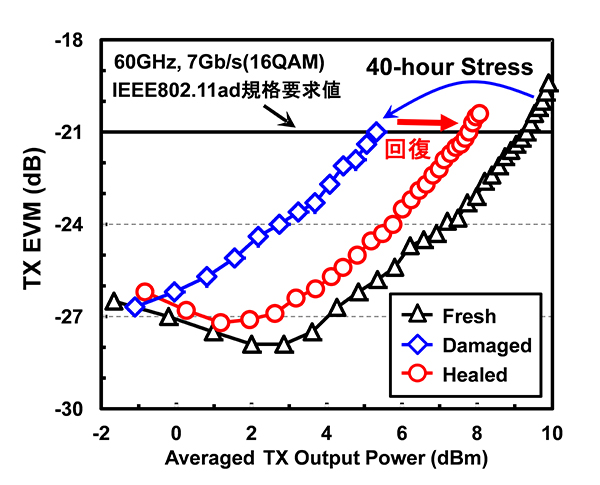
図7. 送信電力の回復
特徴:送信電力がHCIダメージにより減少する(Damaged)が、本技術を用いることにより、出力電力が回復できた(Healed)。60GHz帯ミリ波無線機ではIEEE802.11ad規格で規定されるEVM<=-21dBの変調精度を満たす必要がある。EVM=-21dBの条件で、元々の出力電力が8.5mW(Fresh)であったが、HCIダメージ(電源電圧Vdd=1.5V, 出力電力17.8mWのストレス条件で40時間)により、出力電力が3.4mW(Damaged)にまで減少する。本技術により、6.0mW(Healed)まで回復できることを確認した。
この成果は、2月22日~26日にサンフランシスコで開催された「2015 IEEE International Solid-State Circuits Conference(ISSCC 2015): 2015年IEEE 国際固体回路国際会議」のセッション「Session 19 - Advanced Wireless Techniques」で発表された。講演タイトルは「An HCI-Healing 60GHz CMOS Transceiver(HCI回復機能を実現した高信頼60GHz帯CMOS無線機)」である。現地時間2月25日10時45分から発表された。
なお、本研究は総務省委託研究「電波資源拡大のための研究開発」の一環として実施された。
用語説明
[用語1] ホットキャリア注入(HCI: Hot Carrier Injection) : トランジスタの寿命を決める主要な物理現象の一つ。MOSトランジスタのドレイン-ソース間電界により加速されたキャリア(ホットキャリア)がゲート酸化膜に注入され、トランジスタの特性が劣化する。注入されたキャリアは酸化膜中にトラップされ、経時的に増加する。トランジスタの電流値が減少し、回路特性が劣化する。
[用語2] IEEE802.11ad規格 : IEEE802.11ad規格は、IEEE802委員会下のIEEE802.11ワーキンググループが標準化を行った60GHz帯のミリ波を用いる次世代の無線LAN規格であり、最大約7Gb/s(プリアンブル含まず)の無線通信が可能である。現在市販されている2.4GHz帯や5GHz帯の無線LANに次ぐ、次世代無線LANとして実用化が進められている。
論文情報
掲載誌 : |
2015 IEEE International Solid-State Circuits Conference(ISSCC 2015): 2015年IEEE 国際固体回路国際会議 |
論文タイトル : |
An HCI-Healing 60GHz CMOS Transceiver(HCI回復機能を実現した高信頼60GHz帯CMOS無線機) |
著者 : |
Rui Wu (博士課程学生), Seitaro Kawai (河合誠太郎:修士課程学生), Yuuki Seo (瀬尾有輝:修士課程学生), Kento Kimura (木村健将:修士課程学生), Shinji Sato (佐藤慎司:修士課程卒業生), Satoshi Kondo (近藤智史:修士課程卒業生), Tomohiro Ueno (上野 智大:修士課程卒業生), Nurul Fajri (修士課程学生), Shoutarou Maki (眞木翔太郎:修士課程学生), Noriaki Nagashima (永島典明:修士課程学生), Yasuaki Takeuchi (竹内康揚:修士課程卒業生), Tatsuya Yamaguchi (山口達也:修士課程卒業生), Ahmed Musa (博士課程卒業生), Masaya Miyahara (宮原正也:助教), Kenichi Okada (岡田健一:准教授), and Akira Matsuzawa (松澤昭:教授)
|
問い合わせ先
東京工業大学大学院理工学研究科電子物理工学専攻
准教授 岡田健一
Email : okada@ssc.pe.titech.ac.jp
Tel : 03-5734-2258
Fax : 03-5734-3764