東工大ニュース
東工大ニュース
公開日:2018.06.22
東京工業大学 工学院 電気電子系の角嶋邦之准教授と科学技術創成研究院 未来産業技術研究所の筒井一生教授らは、ストライプ状に形成したpn接合ダイオード[用語2]の電流-電圧特性を測定することにより、パワーデバイス用シリコンウエハーの少数キャリア寿命を抽出する新しい評価方法を確立した。
少数キャリアはウエハー内部に2次元的に拡散するため、ウエハー裏面に到達しにくくなるが、pn接合ダイオードの測定からストライプの間隔依存性[用語3]を解析することで、少数キャリアの寿命を得ることができるようになる。この手法では、長寿命のウエハーの評価が可能となる。
この評価方法はプロセス評価のみならず、シリコンパワーデバイス製造ウエハーに同時に作り込むことができるため、実際のデバイスの少数キャリア寿命に近い値が得られる。さらに、量産時のウエハー間の特性変化もモニターすることができるようになる。一方、本手法はシリコンだけでなく、ほかのワイドバンドギャップ[用語4]の半導体デバイスにも応用することができる。
研究成果は米国ハワイで開催される「2018 Symposia on VLSI Technology and Circuits(大規模集積回路シンポジウム)」で、現地時間6月20日に発表された。
高耐圧で低損失なシリコン絶縁ゲートバイポーラトランジスタ[用語5](Si-IGBT)を実現するためには、基板内の少数キャリア寿命を正確に制御する必要がある。しかし、その製造プロセスによってはシリコンウエハー内に欠陥が発生し、少数キャリア寿命が短くなる課題がある。そのため、少数キャリア寿命の劣化が少ない、適切な製造プロセスを用いる必要があり、その選択をするための評価方法が求められてきた。
従来から用いられている製造プロセス評価は、新たにシリコンウエハーに製造プロセスを施し、光照射による電気伝導度変化を用いて少数キャリア寿命の評価を行ってきた。しかし、長い少数キャリア寿命を有するウエハーでは、ウエハー中ではなく、表面と裏面の再結合が支配的となり、正しく評価することは困難だった。また、パワーデバイスとは別のウエハーを用いるため、実際のパワーデバイスと特性が異なる懸念もあった。
Si-IGBTの最適製造プロセスの選択を可能とする少数キャリア寿命の電気的評価手法を提案した。Si-IGBTで要求される少数キャリア寿命は長く、耐圧に必要なウエハーの厚さでは、ショックレーのダイオード方程式[用語6]を用いて導出することは困難である。
そこで、図1のようにストライプ状にpn接合ダイオードを形成し、その電流-電圧特性を測定することで、少数キャリア寿命を抽出するテストパターン(Test Element Group、TEG)を構築した。この構造では先に記したように少数キャリアはウエハー裏面に到達しにくくなるが、pn接合ダイオードの測定からストライプの間隔依存性を解析することにより、少数キャリア寿命を得ることができる。
デバイスシミュレーター[用語7]を用いた数値計算では、電流-電圧特性に明瞭なストライプの間隔依存性が見られた。特性に変化がなくなる十分広い間隔を図2に示すようにWp,maxパラメータ[用語8]と定義したところ、設定した少数キャリア寿命との関係式を得ることに成功した。
以上の知見により、次世代のSi-IGBTに用いるゲート絶縁膜形成プロセスの評価を行った。比較した製造プロセスは、1,050 ℃で13分間と1,100 ℃で5分間の2工程である。また、用いるウエハーの少数キャリア寿命を知るため、ゲート絶縁膜形成プロセスのない試料を参照にした。試作したダイオードを図3に示す。
この手法でpn接合ダイオードの測定と得られたWp,maxパラメータによる解析を行った結果、ダイオード試作のみのウエハーでは少数キャリア寿命が60μ秒だったのに対し、1,050 ℃で13分間の酸化工程では33μ秒、1,100 ℃で5分間の酸化工程は18μ秒と劣化することが分かった(図4)。以上の結果から1,050 ℃で13分間の酸化工程がより適している試作プロセスであることを明らかにした。
同手法の利点として、Si-IGBTと同じウエハーに作りこむことができるため、実デバイスに近い少数キャリア寿命の評価が可能となる点が挙げられる。また、ワイドバンドギャップ半導体で研究されている超高電圧のデバイス評価にも展開が可能である。
この研究は新エネルギー・産業技術総合開発機構(NEDO)の「新世代Si-IGBTと応用基本技術の研究開発」(代表:平本俊郎東京大学教授)で行った。
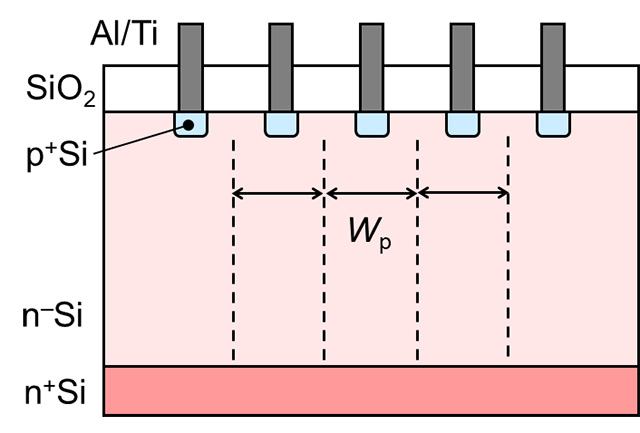
図1. 提案するテストパターンの断面図。ストライプ状のpn接合ダイオードをWpの間隔で形成し、中心のダイオード特性を測定することで、少数キャリア寿命を抽出することができる
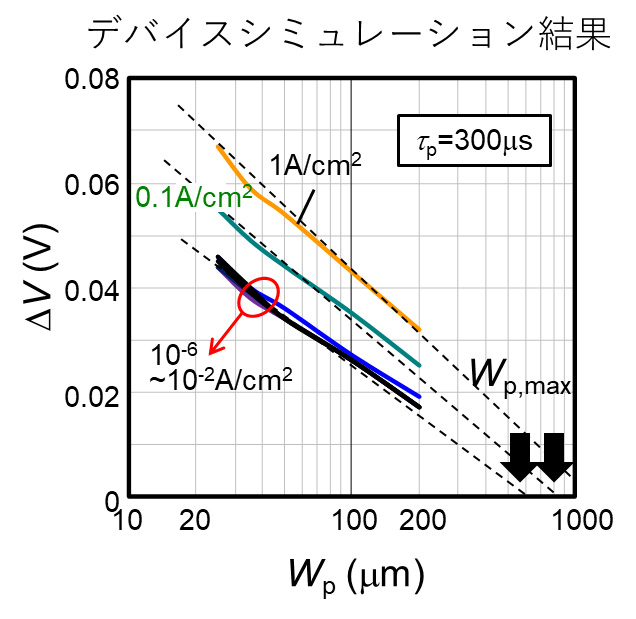
図2. ストライプの間隔(Wp)を広くすると、Nベース領域の抵抗が小さくなる。縦軸のΔVは十分にWpの幅の広いダイオードと、同じ電流を流した際に必要な電圧の違い
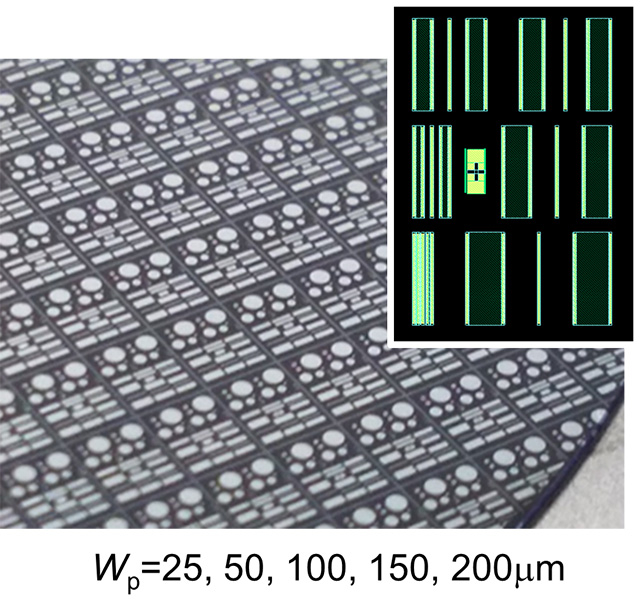
図3. 試作したストライプ状のダイオードパターン

図4. 提案する手法で抽出したゲート絶縁膜形成プロセスの少数キャリア寿命
省エネルギー化を進めるためには、パワーデバイスを用いてインバータなどの電力制御システムを高効率化することが必須である。鉄道や電気自動車など高電圧が用いられる社会インフラ分野ではSi-IGBTが用いられており、今後さらなる高性能化が要求されている。
Si-IGBTはウエハー裏面にあるP型電極から注入された正孔が、ウエハー内部のN型ベース内に少数キャリアとして蓄積されることで、低い抵抗を実現している。N型ベース内の正孔の濃度はN型ベース内の少数キャリア寿命が大きく関与しており、スイッチングを考慮して適切な値に設定する必要がある。
パワーデバイスを製造するプロセスには、少数キャリア寿命を劣化させる原因が存在する。例えば、ウエハー内部に存在する酸素や窒素、炭素といった原子が欠陥となる場合やプロセス装置や環境から入り込んだ重金属汚染による欠陥など多数の要因が存在し、特に熱処理プロセスにおいて入り込むことが知られている。そのため、純度の高いウエハーを用いて、清浄度の高いプロセス装置・環境で製造することが必要である。
少数キャリアの長寿命を実現するためにはウエハー内の欠陥形成を最小化することができるプロセスや装置を用いることが必須である。不純物の少ないウエハーを用いることはもちろん、熱処理温度や時間などのプロセスパラメータを最適な条件にする必要がある。
従来、用いられてきたプロセス評価はデバイスとは別にシリコンウエハーを用意して行ってきた。少数キャリアを発生させるためにウエハーに光照射し、電気伝導度の変化を測定することで、少数キャリア寿命を抽出してきた。しかし長寿命の少数キャリアを有するウエハーでは表面と裏面に存在する欠陥で再結合が起こり、ウエハー内部の少数キャリア寿命を正しく評価することは困難だった。
そのため、ウエハーの表面と裏面の欠陥の影響を受けずに、正確に少数キャリア寿命を測定する手法が望まれていた。一方、パワーデバイスとは別のウエハーを用いるので、実際のパワーデバイスと特性が異なる懸念もあり、パワーデバイスを製造するウエハーで少数キャリア寿命を評価する手法が望まれていた。
Si-IGBTの高性能化は通電時の抵抗損失とスイッチング損失の低減である。2014年から産学官で開始されたNEDOプロジェクトは、スケーリング技術によって新しいSi-IGBT構造を設計してきた。その結果、ウエハー内部のNベース領域[用語9]に正孔を高密度に蓄積する技術を示し、通電時の抵抗損失を大幅に低減することを実験的に示している。一方のスイッチング損失に関しては、Nベース領域の少数キャリアである正孔の寿命を適切な値に制御する必要がある。
Si-IGBTの製造ではゲート酸化や不純物拡散など高い温度で熱処理を行うプロセスが存在し、ウエハー内部の内因性の欠陥やプロセス装置・環境による外因性の不純物欠陥によって、少数キャリア寿命が低下する。少数キャリア寿命はウエハー内部の欠陥量で劣化するため、製造では長い値を維持しておく必要がある。
特に高耐圧のSi-IGBTでは、100μ秒程度の長い少数キャリア寿命が要求される。そのため、温度や時間などの少数キャリア寿命を劣化させないプロセス条件を選択することが必要である。従来、行われている光学測定でも最適なプロセス条件の探索は可能だが、面積やプロセス互換性から、製造するパワーデバイスと同一のウエハーで評価行うことはできない。
そこで、最適なプロセス条件を探索するために、パワーデバイスを製造するウエハーで少数キャリア寿命を評価する手法の開発に取り組んだ。そのため、少数キャリアを光照射によって励起するのではなく、実際のパワーデバイスと同様にP型電極から注入して拡散させ、その寿命を測定することにした。
今回開発した手法はシリコンだけでなく、炭化シリコン(SiC)やダイヤモンドに代表されるパワーデバイス用のワイドバンドギャップ半導体にも同様に用いることができる。今後は多様な応用が期待される。
用語説明
[用語1] 少数キャリア寿命 : 半導体中で数が少ないほうのキャリアが、多数キャリアと再結合するまでの時間。N型では正孔、P型では電子が少数キャリアとなる。少数キャリアを半導体中に注入、あるいは光によって発生することで、半導体の抵抗を下げることができる。
[用語2] pn接合ダイオード : P型半導体とN型半導体を接合した素子で、整流作用を示す。ここでは、濃度の高いP型半導体とN型半導体を接合しており、N型半導体をNベースと呼ぶ。順方向バイアス時には、P型半導体から正孔がN型半導体に注入され、Nベース領域の抵抗が小さくなる特徴がある。
[用語3] ストライプの間隔依存性 : 順方向バイアス時には、正孔がN型半導体中に広がって伝導する。ストライプの間隔(Wp)が狭いpn接合ダイオードでは、隣同志のpn接合ダイオードから注入された正孔が混ざるが、間隔が広い場合は混ざらすに伝導する。正孔が混ざらなくなる間隔をWp,maxパラメータと定義する。
[用語4] バンドギャップ : 結晶のバンド構造の禁制帯のエネルギー幅で、価電子帯の上部から伝導帯の下部までのエネルギーの差である。バンドギャップの幅が広いと絶縁体、狭いと半導体になる。ワイドバンドギャップの例として炭化ケイ素(SiC)が挙げられる。
[用語5] 絶縁ゲートバイポーラトランジスタ : IGBT(insulated gate bipolar transistor)ともいう。エミッタ電極とコレクタ電極の間の電流を、絶縁層を介したゲート電極に加える制御電圧信号により制御するトランジスタ。高電圧、大電流を直接オン・オフできる高性能パワートランジスタとして広く用いられている。
[用語6] ショックレーのダイオード方程式 : pn接合ダイオードの電流―電圧特性を示した方程式。少数キャリア寿命が特性に大きな影響を与える。
[用語7] デバイスシミュレーター : 半導体デバイスの内部構造を設定し、数値計算でデバイス動作を確認する手法。
[用語8] Wp,maxパラメータ : 隣同士のpn接合ダイオードから注入された正孔がお互いに混ざらない十分なストライプ間隔。
[用語9] Nベース領域 : 高い電圧に耐えるために導入するN型半導体の領域。IGBTの抵抗の大部分を占めるため、正孔の蓄積を行うことによって、低抵抗化を実現する。
講演情報
国際会議 : |
|
講演セッション : |
Session 10, Power Devices and Circuits |
講演時間 : |
June 20th, 13:55 - 14:20 |
講演タイトル : |
New Methodology for Evaluating Minority Carrier Lifetime for Process Assessment |
お問い合わせ先
東京工業大学 工学院 電気電子系 准教授
角嶋邦之
E-mail : kakushima.k.aa@m.titech.ac.jp
Tel / Fax : 045-924-5148
東京工業大学 科学技術創成研究院 未来産業技術研究所 教授
筒井一生
E-mail : ktsutsui@ep.titech.ac.jp
Tel / Fax : 045-924-5462
取材申し込み先
東京工業大学 広報・社会連携本部 広報・地域連携部門
Email : media@jim.titech.ac.jp
Tel : 03-5734-2975 / Fax : 03-5734-3661