東工大ニュース
東工大ニュース
公開日:2022.03.08
情報機器でのエネルギー消費増大問題を解決するために、計算機用の高性能な不揮発性磁気メモリ(MRAM)[用語1]の開発が求められています。東京工業大学、東北大学国際集積エレクトロニクス研究開発センター、東北大学電気通信研究所、神戸大学、早稲田大学、ブルカージャパン、パリ-サクレー大学、フランス国立研究センターの国内6機関・国外2機関のそれぞれが得意とする専門分野を学際的に協働することにより、結晶系の異なる六方晶系の二次元物質[用語2](グラフェン)と正方晶系の規則合金(L10-FePd)の界面(異種結晶界面)をファンデルワールス力[用語3]により"しなやか"に結合させ、かつ界面電子密度の増加により"つよい"混成軌道が誘起されたため、界面垂直磁気異方性を出現させることに成功しました。さらに、直接観察実験と理論計算の両方からグラフェン/L10-FePdの異種結晶界面の原子位置を正確に決定することに成功しました。本研究により、界面磁気異方性とL10-FePdのもつ高い結晶磁気異方性の両方を利用する道筋が示され、X nm世代[用語4]のMRAM用の微小な強磁性トンネル接合(MTJ)素子[用語5]への利用が期待されます。
本研究成果は、米国化学学会発行の科学誌ACS Nanoの2022年2月28日(米国東部標準時EST)にオンライン掲載されました。
年々増大する情報機器でのエネルギー問題を解決するためには、計算機に用いられている揮発性メモリを不揮発性磁気メモリ(MRAM)に代替していくことが重要となります。現在のMRAMに用いられている強磁性トンネル接合(MTJ)素子は、CoFeB/MgOの界面垂直磁気異方を利用しており、四重界面とすることにより1X nm世代に適合したMRAMの研究開発に成功しています。X nm世代のMRAM用のMTJ素子の実現を目指して、形状磁気異方性の利用、多重界面などが検討されています。そのような状況のなか、X nm世代に向けた新たな材料の選択肢として高結晶磁気異方性を有するL10規則合金も注目されています。しかし、FePt, FePd, CoPt, MnGaなどのL10規則合金とMgOトンネル障壁には約10%の大きな格子ミスフィット率があるため、界面構造が乱れて高品質なMTJ素子を作製することができません。この問題を解決する方法として、我々は二次元物質の間に生じるファンデルワールス力に着目しました。二次元物質はファンデルワールス力により金属と緩やかに結合するため、格子ミスフィットの影響を回避して、平滑な界面を形成する可能性が期待できます。また、二次元物質であるグラフェン、h-BNなどはスピン依存トンネル伝導により1,000%近いトンネル磁気抵抗(TMR)変化率[用語6]が理論的に予測されています。また、MgOトンネル障壁に比べて接合抵抗を低く抑えることができるとも報告されております。これらの二次元物質の特徴はX nm世代のMTJ素子に求められる要求の多くを満たしております。そこで我々は、代表的な二次元物質であるグラフェンをトンネル障壁材料とし、L10-FePd規則合金を記録層とする新しいMTJ素子の研究に着手しました。量産化プロセスを念頭にL10-FePd規則合金層を物理蒸着法であるスパッタ法により、グラフェンを化学蒸着法により製膜し、一貫した真空プロセスを選択しました。以上の背景を踏まえ、グラフェン/L10-FePdのMRAMへの有用性を明らかにするために、本研究では、以下の3つの項目について調べました。
全てを理解するためには界面に特化した専門的な評価が必要になるため、共同研究者の各々の得意とする専門性を集約して、3つの課題に取り組みました。
L10-FePdエピタキシャル膜をマグネトロンスパッタ法によりSrTiO3単結晶基板上に製膜し、その後、化学気相体積法によりグラフェンを成長させることにより、グラフェン/L10-FePdを作製しました。グラフェンはハニカム構造の六方晶、L10-FePdは正方晶の結晶系であり、グラフェン/L10-FePdは異種結晶系により界面が形成されております。この異種結晶界面の界面構造を調べるために、原子間力顕微鏡、X線反射率[用語7]、走査型透過電子顕微鏡を用い、界面磁性を調べるために深さ分解X-ray Magnetic Circular Dichroism(XMCD)を用いました。さらに、異種結晶界面の原子位置は第一原理計算をもとに走査型透過電子顕微鏡像のシミュレーションを行い、実験で得られた像と比較することにより決定しました。
原子間力顕微鏡観察によりFePd表面は平坦となっていることが確認され、その後に製膜されたグラフェンとの界面はX線反射率により平坦な界面であることが明らかとなりました。また、走査型透過電子顕微鏡による直接観察法によりFePdとグラフェンの界面が平坦になっていることが確認されました。従って、ファンデルワールス力による結合は異種結晶界面のように大きな格子ミスフィットが存在しているにもかかわらず界面構造を乱さないことがわかりました。
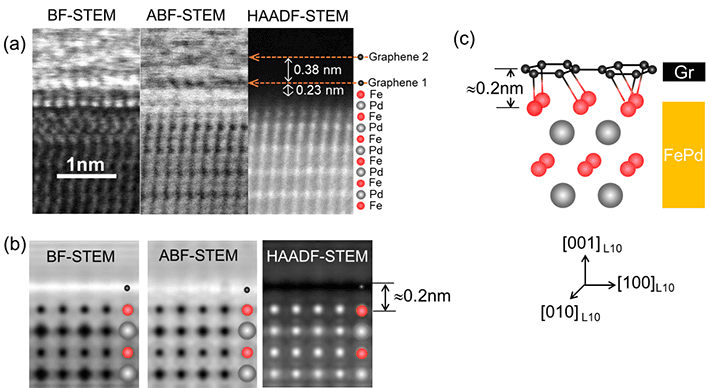
図2(a)に示すように、偏光した軟X線を用いて深さ分解XMCDにより表面からおよそ2.5 nmまでの深さを分割して、磁気特性の深さ方向の変化を調べました。また、磁場は垂直方向および面内方向から30°傾けることにより垂直方向への磁気異方性について評価しました。深さ分解XMCDは高エネルギー加速器研究機構 Photon Factory BL-16のビームラインを利用しております。図2(b)に深さ方向に分解されたXMCDスペクトルを示します。図2(c)に界面付近、図2(d)に内部層の偏光X線による吸収(XAS)スペクトル、およびその差分であるXMCDスペクトルを示します。界面と内部層の垂直入射(θi=90°)XMCDスペクトル(図2(c)および2(d))、および30°に傾けたXMCDスペクトルをそれぞれSUMルールにより解析すると、界面付近の軌道磁気モーメントが垂直方向に異方性を有していました。この結果から、界面垂直磁気異方性が異方的な軌道磁気モーメントにより誘起されていることがわかりました。従って、異種結晶界面には界面垂直磁気異方性が存在していることが明らかとなりました。以上のことから、グラフェン/FePdはFePdの高い垂直結晶磁気異方性に加えて、界面垂直磁気異方性も付与されており、記録情報の高い安定性が期待できることがわかりました。

グラフェンは六方晶系、L10-FePdは正方晶系であるためグラフェン/L10-FePdは異種結晶界面であります。異種結晶界面による大きな格子ミスフィットのある界面原子位置を調べるためには、まずはじめに、第一原理計算を用いてファンデルワールス力による界面が最もエネルギー的に安定になる方位を調べる必要があります。図1(c)に示すように、グラフェンのアームチェアがFePdの面内格子の辺と平行になる原子位置関係が最もエネルギー的に安定であることがわかりました。また、そのときのグラフェンのハニカム構造は維持されていますが、僅かではあるものの正方晶のFePdの原子位置の影響を受けて歪んでいることがわかりました。実際に作製したグラフェン/L10-FePdの相対的な配置がどうなっているかを調べるために、第一原理計算から得られた原子位置をもとに走査型透過電子顕微鏡像のシミュレーションを行いました。図1(b)に計算した走査型透過電子顕微鏡シミュレーション像を示します。グラフェンの面内方向のコントラストの明暗についてラインプロファイルを調べました。その結果、実際の走査型透過電子顕微鏡像の実験像とシミュレーションにより計算した走査型透過電子顕微鏡像が、良い一致を示していることがわかりました。このことは、第一原理計算により予測した界面の原子位置関係が実際の界面において実現していることを意味します。つまり、L10-FePd上のグラフェンはファンデルワールス力のエネルギーが最も安定化する原子位置関係になることが明らかとなりました。グラフェンは僅かに歪みながらもファンデルワールス力により"しなやか"に結合していることがわかりました。
次に、グラフェンとL10-FePdの層間距離を調べたところ、第一原理計算および走査型透過電子顕微鏡観察の両方でおよそ0.2 nmとなっていることがわかりました。また、走査型透過電子顕微鏡観察像ではグラフェンの第一層と第二層の層間距離は0.38 nmであり、グラファイトの層間距離とほぼ一致しておりました。グラフェンとL10-FePdの層間距離が短くなっていることはファンデルワールス力のなかでも"つよい"結合となるChemisorptionタイプであることがわかりました。X線反射率においても界面での電子密度が高くなっていることが判明しており、界面垂直磁気異方性の起源は層間距離の短縮により電子密度の増大および混成軌道が強化されたためと考えられます。以上のような微視的な構造解析を多岐の方法により解析し、界面磁性を説明する試みは少なく、学術的な価値の高い成果となります。
最後に、MRAMへの応用の可能性を検討するために、マイクロマグネティクスシミュレーションを行いました。String法によるマイクロマグネティクスシミュレーションによりグラフェン/L10-FePdの記録情報の熱安定性を調べたところX nm世代においても10年間、記録情報を保持できるほどの十分な垂直磁気異方性であることがわかりました。これは、グラフェン/L10-FePdの界面磁気異方性とL10-FePdの高い結晶磁気異方性の相乗効果による成果であります。グラフェン/FePdの異種結晶界面を利用した微小ドットはX nm世代をターゲットとしたMTJ素子の記録層の1つの候補として有望であることが示唆されました。
本研究により、二次元物質である六方晶系グラフェンと正方晶系規則合金を組み合わせたハイブリッドMTJ素子がX nm世代において有望であることがわかりました。本研究は二層構造でありますが、参照層を加えたMTJ素子としたときの特性を調べていく必要があります。現在、日仏共同研究を主軸に国内とも綿密に連携を取りながら、MTJ素子の研究を遂行しております。また、グラフェンのファンデルワールス力の"しなやか"でありながら"つよい"結合は広く二次元物質に展開することができるため、h-BN、WS2などの二次元物質の多彩な物性と正方晶晶系の高機能金属、高機能酸化物などとの異種結晶界面をファンデルワールス力により繋ぐことで、新しい電子デバイスへの発展が期待されます。
付記
本研究は、東京工業大学、東北大学、神戸大学、早稲田大学、パリ-サクレー大学、フランス国立科学研究センター、およびブルカージャパンとの共同研究の成果であります。本研究における、界面の平均的な構造および電子密度を東京工業大学科学技術創成研究院フロンティア材料研究所の共同利用研究(課題番号73)の支援によりX線反射率法を用いて評価を行いました。また、東北大学および神戸大学は日本学術振興会研究拠点形成事業(Core-to-Core Program, 課題番号JPJSCCA20160005)の支援を受けて、日英仏の3国間の共同研究のもと二次元材料のトンネル障壁への応用について検討してきました。東北大学クロスアポイントメント制度による東北大学とパリ-サクレー大学(Pierre Seneor教授)、フランス国立科学研究センター(Bruno Dlubak研究員)の共同研究成果でもあります。東北大学スピントロニクス学術連携研究教育センターおよび東北大学先端スピントロニクス研究開発センターの支援を受けております。このように多数の機関の共同研究の結果を集約した成果であります。
用語説明
[用語1] 不揮発性磁気メモリ(MRAM) : データの保存に不揮発性である磁化状態を利用しており、DRAMおよびSRAMなどの揮発性メモリの代替により消費電力を低減することができることから次世代メモリとして注目されている。モリセル(データ読み書きの最小単位)に電荷を蓄積することでデータを記録しており、MRAMとは記録原理が異なる。MRAMはメモリセルに、2つの磁性体層の間に絶縁体層を挟み込んだ強磁性磁気トンネル接合(MTJ)という構造をもつ素子を用いる。磁性体の磁化方向(N極とS極)が2層ともそろっている状態が「0」、不ぞろいな状態が「1」をあらわす。
[用語2] 二次元材料(物質) : 二次元の面内方向の結合は強く、面直方向にはファンデルワールス力による弱い結合により貼り合わされている物質のこと。二次元材料としてはグラファイトの1層だけ剥がしたグラフェンに関わる研究が多く行われてきたが、近年、h-BN, WS2など多くの二次元物質の研究が展開されている。
[用語3] ファンデルワールス力 : 原子間に働く分子間力であり、原子位置関係、結晶対称性などにより物理吸着と化学吸着の2種類が二次元物質と金属材料の間では生じるとされている。物理吸着のときの原子間力は化学吸着のときの原子間力に比べて弱く、原子間距離が長くなることが報告されている。
[用語4] 1X nm世代、X nm世代 : 強磁性トンネル接合(MTJ)素子の接合直径のことである。この接合直径が小さくすることで不揮発性磁気メモリ(MRAM)の集積度を高めることができる。現在は1X nm世代の研究開発が盛んに行われており、X nm世代の基礎研究が次々に報告されている。X nm世代では形状磁気異方性の利用、界面数を増やすなどが提案されている。
[用語5] 強磁性トンネル接合(MTJ)素子 : 強磁性/極薄絶縁層/強磁性の3層が基本構造で、1つの強磁性層を記録層、もう1つの強磁性層を固定層として磁化状態を記録する不揮発性磁気メモリへ応用されている。
[用語6] トンネル磁気抵抗(TMR)変化率 : 強磁性トンネル接合(MTJ)素子の2つの強磁性層の磁化が平行のときスピン偏極電子の透過率は高く、反平行のとき透過率は低くなる効果である。磁化の相対角度に応じてMTJ素子の抵抗が変化することから、不揮発性磁気メモリ(MRAM)の読み出しの原理となっている。一般に、磁化の平行・反平行時の電気抵抗を用いてTMR変化率を算出し、TMR変化率が高いとデジタル信号における"0"と"1"の判別が明瞭となる、また磁化反転効率が高くなることからMRAMにおいて重要なパラメーターとなっている。
[用語7] X線反射率 : X線をサンプル表面に斜入射し入射角度依存性を測定することでX線反射率を取得し、その結果と薄膜構造モデルから組み立てた計算値よりサンプルの膜厚、密度、表面および界面粗さ等の薄膜の詳細情報を得ることが可能である。
論文情報
掲載誌 : |
ACS Nano |
論文タイトル : |
Unveiling a Chemisorbed Crystallographically Heterogeneous Graphene/L10-FePd Interface with a Robust and Perpendicular Orbital Moment |
著者 : |
Hiroshi Naganuma(責任著者)1, Masahiko Nishijima1, Hayato Adachi2, Mitsuharu Uemoto2, Hikari Shinya1, Shintaro Yasui3, Hitoshi Morioka4, Akihiko Hirata5, Florian Godel6, Marie-Blandine Martin7, Bruno Dlubak1,7, Pierre Seneor1,7, Kenta Amemiya8 1Tohoku Univ., 2Kobe Univ., 3Tokyo Tech, 4Bruker Jap., 5Waseda Univ., 6Univ. Paris-Saclay, 7CNRS/Thales, 8KEK, Univ. Tokyo |
DOI : |
お問い合わせ先
東北大学国際集積エレクトロニクス研究開発センター 研究開発部門
准教授 永沼博
E-mail : hiroshi.naganuma.c3@tohoku.ac.jp
Tel : 022-796-3419
東京工業大学 科学技術創成研究院
助教 安井伸太郎
E-mail : yasui.s.aa@m.titech.ac.jp
Tel : 03-5734-3060
取材申し込み先
東北大学国際集積エレクトロニクス研究開発センター
支援室長 髙橋嘉典
E-mail : support-office@cies.tohoku.ac.jp
Tel : 022-796-3410 / Fax : 022-796-3432
東京工業大学 総務部 広報課
E-mail : media@jim.titech.ac.jp
Tel : 03-5734-2975 / Fax : 03-5734-3661