東工大ニュース
東工大ニュース
公開日:2022.09.13
東京工業大学WOWアライアンス[用語1]は、台湾国立成功大学[用語2](以下、成大)と BBCube(Bumpless Build Cube)[用語3]に基づく次世代三次元集積技術[用語4]の社会実装(実用化)に向けた技術協力に合意しました。次世代三次元集積に対する日台アカデミアのアライアンスは初めての試みであり、今後はBBCubeビジネスアライアンスを通して量産化の実現に向け、計画を進めます。成大は東工大WOWアライアンスに加盟し、次世代三次元技術の研究開発を行うとともに、成大内にBBCube試作ラインを構築・運用し、併せて人材育成を実施する予定です。
成大では、東工大 科学技術創成研究院 大場隆之特任教授の設立した株式会社テック・エクステンション(以下、TEX)とBBCubeビジネスアライアンスが締結され、BBCube技術のプラットフォームであるWOW技術[用語5]とCOW技術[用語6]がTEXから技術移管されます。この技術移管では、これまで東工大WOWアライアンスで得られた成果をもとに、プロセス・装置・材料が利用されます。
現在、東工大WOWアライアンスには多くの大学、関連企業などが参画し、次世代半導体三次元技術の研究開発を行っています。最先端半導体が抱える課題、すなわち原子レベルの見えない欠陥(invisible defect)の増加で歩留まりが飽和する時代を迎え、COWによるチップレット集積とWOWウエハ積層技術が一層重要になります。今回の日台連携は、これらのニーズに対して応えるものであり、プロダクトアウトとマーケットインをシームレスにし、半導体サプライチェーンが強化されるとともにポスト微細化としての三次元集積技術の基礎開発と社会実装が大きく前進することが期待されます。今後2023年末までには、成大に研究開発の試作ラインを立ち上げ、BBCubeのプラットフォームであるWOW技術とCOW技術が順次適用される予定です。

図1. WOWアライアンスとBBCubeビジネスアライアンス
東工大WOWアライアンスは研究成果を社会実装(実用化)する事を目的とし、東工大発ベンチャーとしてTEXを2018年に設立しました。今回新たに、TEXが成大産學創新總中心(Innovation Headquarters)とビジネス協定を締結し、成大にBBCubeビジネスアライアンスを設立します(図1)。東工大WOWアライアンスで創成された研究成果は、同社傘下の台灣梯意愛克思股份有限公司(TEX Taiwan)を通じて提供されます。
BBCubeビジネスアライアンスには、後工程製造受託企業(OSAT: Out-sourced Semiconductor Assembly and Test)、デバイス製造企業などの参加を予定しており、より一層の社会実装に向けた加速が期待されます。
また、成大の敷地内にBBCubeアーキテクチャーに基づくWOW/COW技術の試作開発用ラインを構築し、2022年末から始まるフェーズ1では装置実装に合わせた研究プログラムに沿って研究開発を行い、2024年度にはフェーズ2として一貫ラインとなる設備の充実を行います。この一貫ラインでは、チップレットの集積をウエハスケールかつワンストップで行うことができるため、フロントエンドのみならず、バックエンドにわたりシームレスに検証することができます。

図2. システムの小型化を可能にするBBCubeアーキテクチャー
WOWアライアンスで開発したBBCubeでは、すべての構成デバイス(メモリ、CPU、コンデンサなど)に対し配線を最短で行うことができます(図2)。例えば、コンデンサとデバイスの距離は、ミリメートルからミクロンレベルに短縮することができます。WOWアライアンスでは熱設計も含め、親指サイズのさらなる小型化を目指して設計・プロセス・装置・材料の協調開発を進めています。
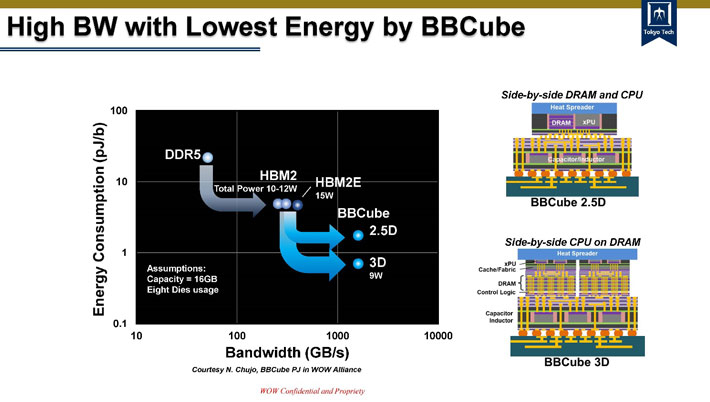
図3. ビット伝送当たりの消費エネルギーと伝送帯域の関係
さらに、サーバーなどハイエンドに利用されているHBM[用語7]の消費エネルギーは、従来のDDR5[用語8]に比べ約5分の1まで小さくなります。BBCubeを利用した2.5Dや3Dでは、伝送帯域を毎秒テラバイトとしても、ビット当たりの伝送エネルギーがHBMに比べ一桁小さく、システムの消費電力は世界最小(<10 W)になります(図3)。

図4. Wafer薄化技術とTSVによる上下配線技術
従来は、電極部にメッキで形成した配線接続のための突起状のバンプ電極があり、バンプの抵抗と高密度化が障害となり高速化と積層化の課題になっていました。
BBCubeのようにバンプを使わないバンプレス技術は、このような課題を解決することができます。WOWアライアンスではウエハをミクロンレベルまで薄くする薄化技術や、上下配線をTSV[用語9]で直接接続しウエハを何枚も積層できる技術を開発しています(図4)。この技術をDRAMに応用すると、積層数とともに大きなメモリ容量が実現できます。これは特に膨大なメモリ空間を必要とするAIに応用することができます。同アライアンスでは、バンプレスCOWも開発しており、バンプレスでチップとウエハを上限配線することができ、これにより異なるデバイスを組み合わせたチップレット集積が可能になります。
BBCubeシステムのバンプレス配線はチップ間の上下配線にバンプを用いず最短で接続する技術です。バンプを用いない分、抵抗、電気容量が小さくなり、さらにウエハの超薄化技術(Si厚さ<4ミクロン)を利用することで、TSVの配線長はウエハ厚さとなり、さらに電気特性が改善されます。バンプの制約がなくなるため、TSVの配線密度はリソグラフィーの進化とともに高密度にすることができ、従来課題となっていたチップ面積におけるTSVの専有面積が小さくなります。このためチップ内で分散配置することでチップとチップの上限配線を並列で行うことができます。
DRAMチップでは、メモリをチップ内で分割し並列で上下配線すれば、従来チップ平面上で行っていた長距離信号伝送や電力供給を分割数にしたがい並列かつ短距離で上下接続ができます。この並列性から、伝送速度を低くしても同じ伝送帯域を維持しながら消費電力を低くすることができます。
高密度バンプレスTSVのもう1つの利点は、熱の散逸が良くなることです。従来、長いTSV配線とバンプで積層とともにチップ内部の温度が上昇して温度による積層限界がありましたが、同技術を利用することで積層限界が大幅に緩和されます。
用語説明
[用語1] WOWアライアンス : 東京工業大学 科学技術創成研究院 異種機能集積研究ユニット(大場研究室)が中心となって運営される産学研究プラットフォーム。半導体関連の設計・プロセス・装置・材料などを手がける企業、および研究機関によって構成される。三次元開発としては国内唯一300ミリウエハを利用した実証開発、高度かつ簡便なウエハの薄化技術・積層技術を持ち、バンプレスTSV配線を用いた三次元化技術を世界で初めて開発に成功した。
[用語2] 台湾国立成功大学 : 1931年に創設された国立総合大学であり、台湾中南部で最難関大学として知られ、指定国立研究大学6校の1つである。英語:National Cheng Kung University(NCKU)、公用語表記:國立成功大學(Wikipedia日本語版「国立成功大学」より引用)。東工大と成大は、1997年11月に学術交流協定を締結している。
[用語3]
BBCube(Bumpless Build Cube) : 従来の平置きチップレットを三次元でコンパクトにまとめ、バンプを利用しないでシステムの小型化を可能にするアーキテクチャー。
参考:Ohba, T.; Sakui, K.; Sugatani, S.; Ryoson, H.; Chujo, N. Review of Bumpless Build Cube (BBCube) Using Wafer-on-Wafer (WOW) and Chip-on-Wafer (COW) for Tera-Scale Three-Dimensional Integration (3DI). Electronics 2022, 11, 236. DOI: 10.3390/electronics11020236
[用語4] 次世代三次元集積技術 : ウエハレベルで三次元集積を行う次世代半導体技術。WOWアライアンスが保有する超薄化技術、バンプを除いた垂直配線技術で半導体の三次元集積を行い、従来よりも高性能・低消費電力を実現することができる。またサーバーなどの大規模演算デバイスだけでなく、搭載される異種機能デバイスシステムの超小型化が可能になる。
[用語5] WOW技術 : Wafer-on-Wafer技術の略で、ウエハ上にウエハを接合しながら接続配線し、何枚も積み上げることができる積層技術。DRAMなど同一チップサイズのウエハ積層の生産性向上に大きく寄与する。
[用語6] COW技術 : Chip-on-Wafer技術の略で、チップレットをウエハ上に接合しながらWOW技術で接続配線する技術。チップをウエハ上に接合することにより、以降の半導体製造工程において、各種ウエハプロセス装置を用いた高精度な加工が行えるようになる。
[用語7] HBM : High Bandwidth Memoryの略。JEDECが規格化した、Through Silicon Via (TSV)技術によるダイスタッキングを前提としたメモリ規格。(Wikipedia日本語版「High Bandwidth Memory」より引用)
[用語8] DDR5 : DDR5 SDRAM (Double Data Rate 5 Synchronous Dynamic Random-Access Memory)の略。半導体集積回路で構成されるDRAMの規格の一種であり、複数のDRAMチップをプリント基板上に搭載したメモリモジュール(DIMM = Dual Inline Memory Module)として、コンピュータの主記憶として利用される。前世代のDDR4 SDRAMと比較して、DDR5は消費電力を削減しつつ帯域幅が2倍になる。(Wikipedia日本語版「DDR5 SDRAM」より引用)
[用語9] TSV : Through-Silicon-Viaの略で、シリコン(Silicon)ウエハを貫通(Through)させて開けた接続孔(Via:ビア)。上下に積層したチップを、埋め込み配線によって接続させる。最近では、シリコン材料以外にも配線するため、前工程における垂直配線(vertical interconnects)と言い換えることができる。
お問い合わせ先
東京工業大学 科学技術創成研究院 異種機能集積研究ユニット
秘書 沼澤文恵、技術 福田匡志
Email numazawa.f.aa@m.titech.ac.jp、fukuda.t.an@m.titech.ac.jp
Tel 045-924-5866
取材申し込み先
東京工業大学 総務部 広報課
Email media@jim.titech.ac.jp
Tel 03-5734-2975 / Fax 03-5734-3661